在材料科學與失效分析領域,準確獲取材料的元素構成是破解諸多技術難題的關鍵步驟。材料成分分析的利器:X射線能譜(EDS)技術原理解析,正是為了幫助研發與工藝人員深入理解這一核心技術。
廣電計量依托其構建的覆蓋半導體全產業鏈的前沿檢測分析體系,利用場發射掃描電鏡(FESEM)配合高精度EDS探測器,可實現從硼(B)到鈾(U)的元素范圍分析,具備微區點分析、線掃描和面分布等多種分析模式。無論是半導體材料中的異常顆粒,還是金屬合金的析出相,我們的技術專家都能通過EDS技術精準捕捉元素信息,為工藝優化與失效歸因提供確鑿的數據支撐。
在半導體制造領域,材料表面納米級的化學污染、氧化及元素偏析問題,已成為影響器件電性能、可靠性和工藝穩定性的關鍵瓶頸。
主要應用包括:
·通過元素含量/價態對比封裝基板表面工藝處理效果
·通過元素含量/價態對比器件是否受到污染
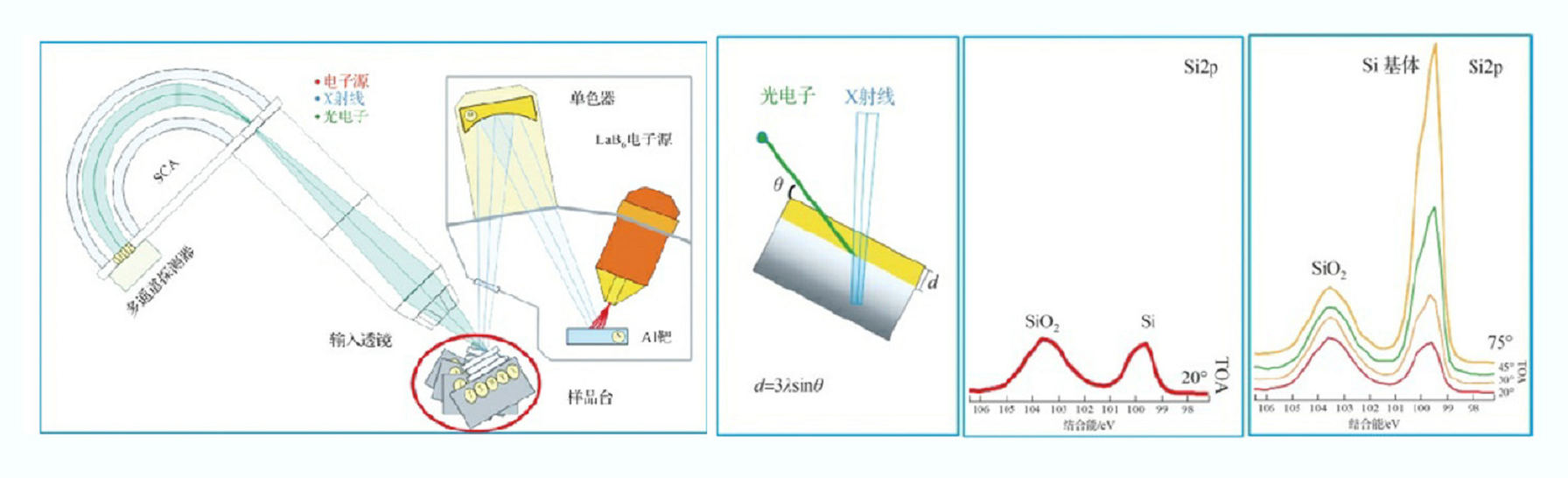
封裝基板通過不同plasma處理方式后表面元素對比

正常線纜與失效線纜元素對比
